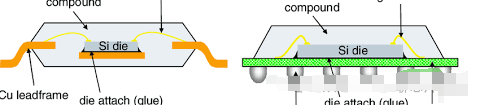
Jak pokazano na powyższym rysunku, podłoża opakowaniowe dzielą się na trzy główne kategorie: podłoża organiczne, podłoża z ramą ołowianą i podłoża ceramiczne. Główną funkcją podłoża opakowaniowego jest zapewnienie fizycznego wsparcia dla chipa, umożliwienie przewodnictwa elektrycznego pomiędzy obwodami wewnętrznymi i zewnętrznymi chipa, a także rozpraszanie ciepła.
1. Substrat organiczny:
Łącznie z żywicą BT, FR4 itp., podłoża organiczne mają dobrą elastyczność i niski koszt.

2. Podłoże ramy prowadzącej:
Podłoże wykonane z metalu, powszechnie stosowane w tradycyjnych opakowaniach, charakteryzujące się dobrą przewodnością i wytrzymałością mechaniczną.
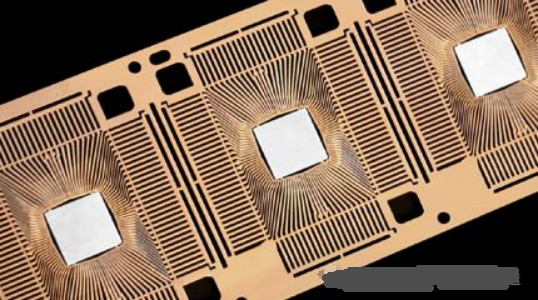
3. Podłoże ceramiczne:
Typowe materiały to tlenek glinu i azotek glinu, odpowiednie do chipów dużej mocy.
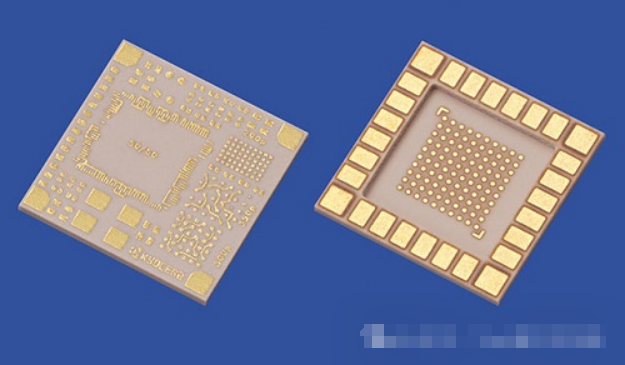
W kolejnej nowości dowiemy się, jakie metody pakowania uwzględniają każdy z trzech typów podłoży.

 Polski
Polski English
English Español
Español Português
Português русский
русский français
français 日本語
日本語 Deutsch
Deutsch Tiếng Việt
Tiếng Việt Italiano
Italiano Nederlands
Nederlands ไทย
ไทย 한국어
한국어 Svenska
Svenska magyar
magyar Malay
Malay বাংলা
বাংলা Dansk
Dansk Suomi
Suomi हिन्दी
हिन्दी Pilipino
Pilipino Türk
Türk Gaeilge
Gaeilge عربى
عربى Indonesia
Indonesia norsk
norsk اردو
اردو čeština
čeština Ελληνικά
Ελληνικά Українська
Українська Javanese
Javanese فارسی
فارسی தமிழ்
தமிழ் తెలుగు
తెలుగు नेपाली
नेपाली Burmese
Burmese български
български ລາວ
ລາວ Latine
Latine Қазақ
Қазақ Euskal
Euskal Azərbaycan
Azərbaycan slovenský
slovenský Македонски
Македонски Lietuvos
Lietuvos Eesti Keel
Eesti Keel Română
Română Slovenski
Slovenski मराठी
मराठी Српски
Српски 简体中文
简体中文 Esperanto
Esperanto Afrikaans
Afrikaans Català
Català עִברִית
עִברִית Cymraeg
Cymraeg Galego
Galego 繁体中文
繁体中文 Latvietis
Latvietis icelandic
icelandic יידיש
יידיש Беларус
Беларус Hrvatski
Hrvatski Kreyòl ayisyen
Kreyòl ayisyen Shqiptar
Shqiptar Malti
Malti lugha ya Kiswahili
lugha ya Kiswahili አማርኛ
አማርኛ Bosanski
Bosanski Frysk
Frysk ជនជាតិខ្មែរ
ជនជាតិខ្មែរ ქართული
ქართული ગુજરાતી
ગુજરાતી Hausa
Hausa Кыргыз тили
Кыргыз тили ಕನ್ನಡ
ಕನ್ನಡ Corsa
Corsa Kurdî
Kurdî മലയാളം
മലയാളം Maori
Maori Монгол хэл
Монгол хэл Hmong
Hmong IsiXhosa
IsiXhosa Zulu
Zulu Punjabi
Punjabi پښتو
پښتو Chichewa
Chichewa Samoa
Samoa Sesotho
Sesotho සිංහල
සිංහල Gàidhlig
Gàidhlig Cebuano
Cebuano Somali
Somali Точик
Точик O'zbek
O'zbek Hawaiian
Hawaiian سنڌي
سنڌي Shinra
Shinra հայերեն
հայերեն Igbo
Igbo Sundanese
Sundanese Lëtzebuergesch
Lëtzebuergesch Malagasy
Malagasy Yoruba
Yoruba